전자제품에서 반도체 부품의 협피치화가 진행됨에 따라 PCB의 회로와 회로 사이의 간격 혹은 Hole과 Hole간의
간격이 줄어듦에 따라 ECM과 CAF의 불량이 증가하게 됐다. 특히 열악한 환경에서 사용되는 Power Supplier나
사용전압이 높아지는 전기 및 수소연료 자동차 분야에선 이들 불량방지에 각별한 노력을 기울여야할 것으로 보인다.
목차
1.Migration 관련된 불량에는 어떤 것들이 있는가?
2.Migration이 발생하려면 어떤 여건이 갖추어져야 하나?
3.ECM과 CAF는 어떻게 다른가?
4.Electro Chemical Migration의 발생 메커니즘과 특징은?
5.CAF 발생 메커니즘과 특징은?
6.Anti CAF 자재란 무엇인가?
7.원판재질, BIas Voltage, Hole간 Pitch가 CAF 불량에 끼치는 영향은?
8.습도가 CAF 불량에 어느 정도 영향을 끼치는가?
9.그림 17의 Hole 구조에서 어느 것이 CAF 발생 위험성이 가장 큰가?
10.CAF Test 조건과 판정 기준은?
11.CAF Test 전 precondition 조건은?
12.E-Corrosion Test와 SIR Test는?
13.HAST란 무엇이며, 언제 하는가?
14.Creep Corrosion은 어떤 불량이며, 어디에서 발생하는가?
15.Migration을 방지하기 위해 어떤 기술이 사용되는가?
이 글에서는 Ion Migration의 발생 메커니즘을 살펴보고 PCB의 원자재의 특성과 어떤 관계가 있고 습도, 외부 오염 및 인가전압 등 사용 환경에 따라 불량이 어떻게 증가하는지 살펴본다. 또한 현재 산업체에서 시행하고 있는 Test 방법과 Conformal Coating 등 불량 방지책을 고찰해 본다.
PCB에서 사용 중 발생되는 Migration 불량에 대해 아래와 같은 Q&A 형식으로 묻고 답하여 이해를 돕고자 한다.
1. Migration 관련된 불량에는 어떤 것들이 있는가?
우선 결론부터 얘기하면 ECM(Electro Chemical Migration), CAF(Conductive Anodic Filament), E- Corrosion(Electrochemical Corrosion), HAST(Highly Accelerated Temperature/Humidity Satress Test) 혹은 PCT(Pressure Cooker Test) 및 Creep Corrosion 등이 있다.
그림 1과 같이 Migration이 발생할 여건이 갖추어지면 회로의 ‘+’극(Anode)에서는 동회로가 Cu++이온으로 바뀌며 녹기 시작하고(Corrosion), ‘-’극(Cathode)에서는 Cu++이온을 받아들여 수지상 동결정(Dedrite)이 Anode 쪽을 향해 성장하기 시작한다.
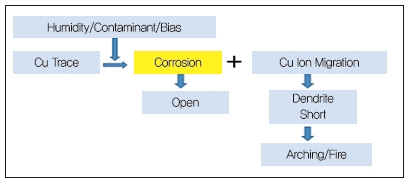
그림 1. Corrosion 및 Migration 발생 메커니즘
반응이 심해지면 Anode(+극)쪽 회로가 부식돼 끊어져 Open이 되고 Cathode(-극)쪽에서부터 성장한 Dendrite가 Anode에 닿게 되어 Short가 발생된다. 또한 그때 발생한 열로 인해 Short 부위가 타버린다.
이와 같이 Corrosion과 Migration은 동시에 일어나는 것이다. 이들 반응의 초기단계에서는 Anode(+극)에서 회로 Corner Edge측의 Solder Mask가 얇은 곳에서 검은 점(Pore)이나 변색이 발견되고, 반응이 더 진전되면 Solder Mask가 들뜨는 현상이 발생한다.
2. Migration이 발생하려면 어떤 여건이 갖추어져야 하나?
Migration이 발생되려면 그림 2와 같이 습도, 오염물질 및 인가전압이 형성돼야한다.

그림 2. 전기화학적 불량 다이어그램
또한 Migration이 진행될 수 있는 ‘Conductive Path’라는 길이 열려있어야 한다.
그림 3을 보면 알 수 있듯이, 온도 또한 Migration을 가속시키는 인자이며 사용된 전압/전류가 높을수록 Migration은 많이 일어난다.
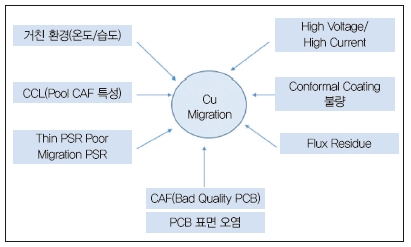
그림 3. Migration에 영향을 미치는 요인
이 외에 원판의 종류에도 영향을 받으며 PCB 표면의 오염, Solder Mask 상태 및 Flux 잔사 등에도 영향을 받는다.
3. ECM과 CAF는 어떻게 다른가?
ECM과 CAF 모두 같은 Migration이지만 ECM은 PCB 표면, 그리고 CAF은 PCB 내부에서 발생되는 불량이라는 면에서 다르다. 또한 CAF은 ECM과 달리 오염물질이 없어도 발생한다. 발생되는 형태도 다른데 ECM이 Corrosion 및 Dendrite 형태인데 반해, CAF는 Filament 형태이다. 이 외에 발생된 불량의 방향도 ECM이 ‘-’에서 ‘+’인데 반해, CAF은 ‘+’에서 ‘-’ 방향으로 형성된다.
다음 장에서 자세히 설명하겠지만 ECM은 PCB의 표면 오염 또는 원판이나 Solder Mask 내 Chlorider와 같은 불순물에 의해 발생되며, CAF은 PCB 내부에서 Drill 같은 기계적인 충격이나 Thermal Damage(Soldering 및 Thermal Cycle Test)에 의해 Glass Bundle과 Epoxy의 접착력이 깨져 그 틈으로 Conductive Path가 형성되어 Filament가 성장되는 점이 다르다(표 1).

표 1. ECM과 CAF 비교
그림 4는 Migration 결과 형성된 Dendrite이며, 그림 5는 CAF에 의해 형성된 동 Filament이다.

그림 4. Migration 결과 형성된 Dendrite(Source : KETI 홍원식)
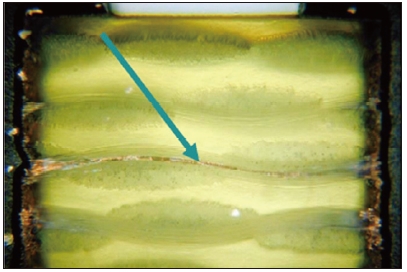
그림 5. CAF에 의해 형성된 동 Filament(Source : Unknown)
4. Electro Chemical Migration의 발생 메커니즘과 특징은?
앞서 설명한 바와 같이 양쪽 회로에 전압이 걸린 상태에서 오염물질(Ionic Contaminant)이 습기에 의해 전해질로 형성되면, 전기분해 반응에 의해 ‘+’극인 Anode에서 회로가 녹기 시작한다(Corrosion).
일반적으로 회로가 Solder Mask에 의해 덮여있기 때문에 Solder Mask 두께가 얇은 Edge 쪽을 뚫고 동이온들이 나오게 된다. 전류는 넓은 면적보다는 날카롭거나 튀어나온 부위를 좋아하기 때문에 Corner쪽에서 흘러나오게 된다.
따라서 Migration Test를 하면 회로 Corner의 Solder Mask가 검게 변하며 Pore가 형성되는 것이다. 반응이 심해지면 Solder Mask가 들뜨게 되고 Migration은 가속된다(그림 6, 7).

그림 6. ECM 메커니즘
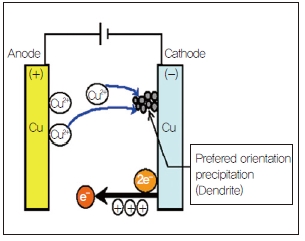
그림 7. Cu Ion Migration 다이어그램
그림 8을 보면 Anode에서 Corrosion이 진행돼 Solder Mask가 변색 되고 Pore가 많이 형성된 것을 볼 수 있다.
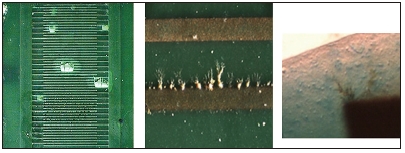
그림 8. 솔더 마스크 Edge에 발생한 Cu Corrosion
또한 부식되며 형성된 Copper Ion들이 Solder Mask를 뚫고 나오는 모습을 볼 수가 있다.
이렇게 Anode를 빠져나온 동이온들은 형성된 Conduc-tive Path를 따라 Cathode쪽으로 이동한다. 이동 후 Cat-hode에서 전자를 받고 금속동이 되며 수지상결정(Dend-rite)을 형성하면서 Anode 쪽으로 뻗어나간다.
Migration Test나 불량이 발생된 샘플을 관찰해 보면 Anode와 Cathode쪽 모두에서 동잔사나 Dendrite를 볼 수 있는데, 그 이유는 이동하던 동이온들이 마르며 붉은색 동염(Copper Salt)이 되기 때문에 양쪽 전극 모두에서 볼 수 있는 것이다.
그림 9는 Corrosion이 일어나 회로가 손상된 사진이다.
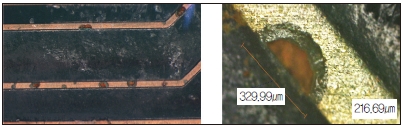
그림 9. Conformal Coating 아래 발생한 Copper Corrosion
380 Volt의 고압이 걸린 제품에서 발생된 불량형태이다. Corrosion으로 인해 Open 불량이 발생됐다.
5. CAF 발생 메커니즘과 특징은?
앞서 설명했듯이 CAF도 Migration의 일종이다. 단지 그 발생 형태와 발생 원인이 다를 뿐이다. DFR Solution과 같은 분석 기관에서는 CAF을 CFF(Conductive Filament Formation)로 부르기도 한다.
그림 10은 CAF 발생 부위를 보여준다. 대부분 CAF은 Glass Bundle면을 따라, 그리고 Epoxy 수지와의 분리된 틈을 따라 발생되는 것을 알 수 있다.
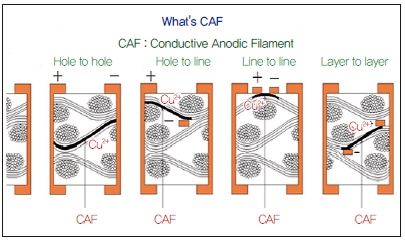
그림 10. CAF 발생 부위(Source : Nanya Plastic)
PCB의 집적도가 증가해 Hole과 Hole간의 간격 좁아짐, 층간 두께 얇아짐 및 회로와 회로 간 간격 좁아짐에 따라 발생 가능성이 높아졌다. 이러한 Glass Fiber와 Epoxy 수지 간 Crack은 Drill 등 기계적인 충격과 열충격 시 Glass와 Epoxy와의 Dimension Mismatch에 의해 발생된다. 일반적으로 Glass의 팽창계수는 5.5이며 Epoxy 수지는 60ppm 정도이다.
일반적으로 Glass 와 Epoxy 수지의 접착력이 약하기 때문에 Glass 표면에 Organo Silane Coupling Agent를 코팅한다. 하지만 깨질 수 있다.
그림 11은 Glass Fiber와 Epoxy간 Crack이 발생돼 그 틈으로 Migration이 발생된 사례를 나타내며, 그림 12에는 CAF 불량이 발생되는 기타 원인을 상세히 설명했다.
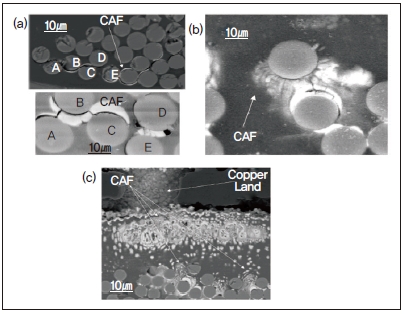
그림 11. Glass Fiber와 Epoxy간 Crack이 발생돼 그 틈으로 Migration이 발생된 사례(Source : Unknown)

그림 12. CAF 불량이 발생되는 기타 원인(Source : DFR Solutions)
층간 쏠림과 Drill 쏠림 또한 절연층 간격을 좁혀 CAF 불량 가능성을 높이며, Wicking 또한 같은 이유로 위험성을 높인다. 이러한 CAF는 Bias Voltage, 습도, 온도가 높아질수록 발생 위험성이 커진다.
그림 13은 Drill 쏠림에 의해 절연층이 감소된 상태에서, Drill 시 기계적인 충격에 의해 Epoxy와 Glass의 접착이 깨져 CAF이 발생돼 제품이 타버린 사례를 나타낸다.

그림 13. Drill 쏠림에 의해 절연층이 감소된 상태에서 Drill 시 기계적인 충격 에 의해 Epoxy와 Glass의 접착이 깨져 CAF가 발생돼 제품이 타버린 사례(Source : Cisco)
Epoxy는 매우 우수한 접착제인데, 최근 사용되는 원판은 내열성을 향상시키기 위해 Dicy에서 Phenolic으로 경화제를 바꿔 접착력이 약화됐다. 또한 CTE를 낮추기 위해 Filler를 첨가해 더욱 약화되는 결과를 불러왔다. 심지어 고속통신 제품에서는 유전율과 유전손실을 낮추기 위해 Cyanate Ester, PPO,PPE 같은 수지를 Epoxy와 Blending해 사용하기에 접착력이 약화됐으며 물성이 순수한 Epoxy에 비해 Brittle 하게 돼 CAF 위험성이 높아졌다
이런 Brittle한 특성을 개선하기 위한 노력의 일환으로 Toughener 사용이 요구된다. 그림 14는 Toughener를 사용함으로써, Drill 시 발생한 Damage와 Wicking이 개선되는 사례를 나타낸다.
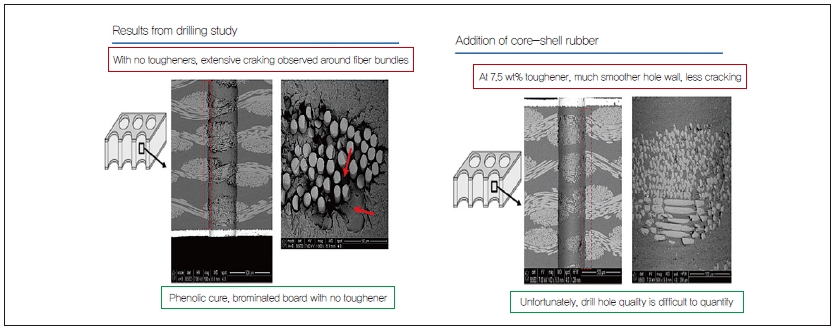
그림 14. Toughener를 사용함으로써 Drill 시 발생한 Damage와 Wicking이 개선되는 사례(Source : Dow Chemical)
물론 CAF 불량 방지에도 도움이 된다. 이러한 Toughener는 Dry Film Solder Mask나 ABF Film에서 사용되는데 원판에서는 어느 정도 사용하는지 파악 중이다.
6. Anti CAF 자재란 무엇인가 ?
원판 회사에서 특별히 Anti CAF 자재로 생산하는 제품은 없다. Phenolic 경화제를 사용한 Lead Free 대응 원판과 Halogen Free원판은 모두 Anti CAF 자재이다. Dicy 경화제는 분자구조상 흡습율이 높아 CAF 위험성이 높고 Pheniolic 경화제는 화학적으로 안정된 결합을 해 Anti CAF특성을 띈다.
7. 원판재질, BIas Voltage, Hole간 Pitch가 CAF 불량에 끼치는 영향은?
그림 15의 초록선은 Dicy, 붉은선은 Phenolic 경화제 원판이며, 그림을 보면 Phenolic 경화제 원판이 월등히 Anti CAF특성이 좋은 것을 알 수 있다.
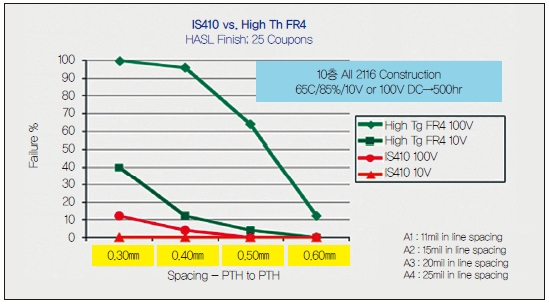
그림 15. Dicy와 Phenolic 경화제 원판의 Anti CAF 특성(Source : Isola)
Bias Voltage도 큰 영향을 끼친다. 일반적으로 ECM/CAF Test를 할 때 반도체 기판 종류는 5 Volt 이하, 통신 기판은 10 Volt, 그리고 전장제품에서는 500V 또는 1,000V Test를 한다. 그림 15에서 보는 바와 같이 10V와 100V의 결과는 하늘과 땅의 차이이다. 그리고 반도체 기판은 회로와 회로 사이 Space가 30um 이하이기 때문에 5V라도 쉬운 Test가 아니다. IPC도 고객과 협의해 500V 나 1,000V를 선택하게 되어있다.
Hole Pitch 또한 회로와 회로 사이의 Space처럼 Critical하다. 일반적으로 Hole Wall과 Wall의 간격이 0.4㎜, 즉 Hole Pitch가 0.9㎜ 이하일 때(Hole Size가 0.3㎜라 가정) CAF 불량은 발생 가능성이 높기 때문에 주의를 기울여야 한다.
Migration불량은 발생 가능성이 점점 더 높아지고 있다. 그 이유는 반도체기판(Package substrate)에서는 세선화(Fine Pattern)로 인해 Space가 좁아지고 있으며, 통신 기판에서는 밀집도(회로폭/층간거리/IO Pitch/Hole Pitch)가 높아지고 있기 때문이다. 또한 전장제품에서는 전기자동차, 수소연료자동차의 출현으로 Power쪽의 사용전압이 600V까지 올라간 것도 원인이다. 일반 자동차도 현재 12V로 가동되는데 연비를 올리기 위해 48V로 전환될 예정이다. Data Center의 DC-DC Module도 현재 12∼42V에서 380V로 올릴 것을 연구 중이다. 이는 전압을 올리면 Power 공급이 원활해져 에너지 절감이 되기 때문인데, 자동자의 경우엔 연비가 개선되는 효과가 있다.
8. 습도가 CAF 불량에 어느 정도 영향을 끼치는가?
그림 16-(a)는 동일한 50C에서 습도를 50%와 80%로 달리해 Time to Failure를 측정한 것이다. 전압이 30V 이상일 때는 둘의 차이가 그리 크지 않은데, 20V 이하일 때는 크게 차이가 난다.

그림 16. 전압과 습도의 Time to Failure에 대한 영향(Source : DFR Solutions)
그림 16-(b)는 온도/습도/Bias 변화에 따른 Time to Failure를 나타낸다.
9. 그림 17의 Hole 구조에서 어느 것이 CAF 발생 위험성이 가장 큰가?

그림 17. Hole 근처의 CAF Failures(Source : Naya Plastic)
결론부터 얘기하자면, CAF 발생 위험이 가장 큰 것은 ‘B’이다.
Drill 시 가장 기계적 충격을 많이 받는 곳은 최외각층이다. 또한 이층은 Prepreg로 이루어져 Lay Up시 금속 이물질이 들어가기 쉬운 곳이다. Drill 시 Glass Bundle이 Cutting 과 Punching의 충격을 받아 Epoxy와의 접착이 깨지면 그 틈으로 CAF불량이 발생한다.
더불어 최외곽층은 흡습이 가장 잘되는 곳이기 때문에 CAF 발생 위험성이 높으며, 이곳은 Drill Bit가 위에서 아래로 들어갔다 나오기 때문에 Bit에 의해 마찰이 가장 오래 발생한다.
원가를 줄이기 위해 가장 굵은 Glass Fiber인 7628 한 장을 외층에 사용할 경우, Glass Strand를 Bit가 Cutting 시킬 때 가장 큰 충격을 받는다는 것을 염두에 두어야 한다.
또한 외곽층은 Soldering과 같은 열 충격 시 Thermal Damage를 가장 많이 받는 곳이며, 이때 Glass와 Epoxy의 접착증이 깨져 CAF 불량 발생 가능성이 높다. 이러한 여러 가지 이유 때문에 어떤 고객은 최외곽층엔 반드시 2장의 Prepreg 사용을 요구하기도 한다. 이렇게 되면 한 장의 Prepreg에서 Crack 이 발생해도 다음장 Prepreg로 연결이 안 되기 때문에 Conductive Path 가 형성되지 않아 CAF 불량이 차단되는 것이다.
그림 18은 B Type의 CAF 불량으로써, Filament가 형성되며 이로 인해 타버린다.

그림 18. Glass Bundle옆의 CAF(Source : Unknown)
10. CAF Test 조건과 판정 기준은?
현재 ECM(Electro Chemical Migration) Test 조건은 CAF Test에 흡수돼 CAF Test를 할 때 이 두 가지 테스트를 함께 표면의 Comb Pattern을 이용해 ECM Test를 실시한다.
표 2에서 보는 바와 같이 대부분 Jungle Test라는 80%/85C 조건에서 실시한다.
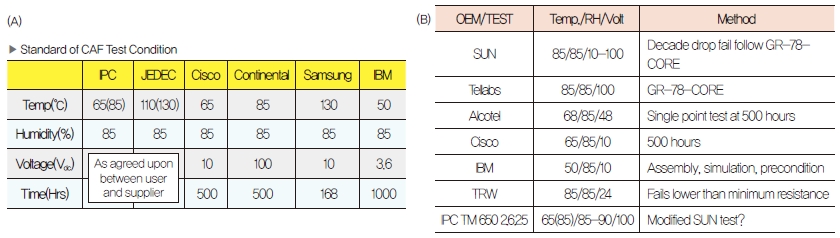
표 2. CAF Test 조건(Source: Samsung Electronics and Nelco)
Test 시간은 500hr 및 1,000hr을 채택하는 추세다. 아래 표 2-(a)의 삼성社의 조건은 HAST(Pressure Cooker Test )조건을 말한다.
판정 기준은 업체에 따라 다르나 일반적으로 최소값이 10MΩ(통신업체 C사) 이상이면 합격이고, 최초 측정치에서 1 Decade Drop(통신업체 C사)이면 불합격이다. 통신업체 C사는 Telcordia Spec인 GR-78을 따르고 있다. 전장업체 C사의 경우 100MΩ 이상과 2 Decade 이하 Drop이면 합격이고 10MΩ 이하와 3 Decade 이상의 Drop이면 불합격으로 정의하고 있다.
표면 검사는 GR-78경우 10배 확대경으로 관찰할 때 Dendrite가 Space를 20%이상 감소시키거나 Cotton Swab 로 문질러 Solder Mask가 묻어나거나 표면의 Solder Mask가 끈끈해지거나 변형이 생겼을 경우 불합격이다(IPC-TM-650의 Method 2.6.11에 의한 검사).
전장업체 C사의 표면 합격 기준은 Dendrite나 Corrosion 발생 자체가 불량은 아니지만 50배로 관찰했을 때 보이면 불합격이다. 하지만 Solder Mask나 Finish의 변색은 허용한다.
그림 19는 전형적인 CAF Test 결과이다.

그림 19. CAF Test 결과
Test 전과 완료 후 실온 조건에서 저항값이 올라가며, 원판특성이 나쁘거나 PCB가 불량일 때는 저항값이 떨어진다. 그림을 보면 Burnt가 발생했다는 것을 알 수 있는데 이 정도면 고객에 따라 합격이라 판단할 수도 있고 불합격이라 판단할 수 있다. 저항값이 떨어지지 않았으면 합격이라 볼 수도 있지만, 고객사의 기준에 따라 다른 부분이다.
11. CAF Test 전 precondition 조건은?
CAF Test 전의 Precondition은 업체마다 다르지만, 통신업체 C사는 As Is, 6X, 10X 의 Lead Free Reflow(260C Peak)를 요구하고 있으며, 전장업체 C사는 3X(Lead Free Reflow)를 요구한다.
원자재의 내열성이 부족할 때는 Multiple Reflow 도중 미세한 Delamination이 발생하거나 Glass와 Epoxy의 접합면이 깨져 CAF 불량 발생 위험성을 증가시킬 수 있다.
12. E-Corrosion Test와 SIR Test는?
Electrochemical Corrosion Test 혹은 SIR(Surface Insulation Resistance) Test는 CAF Test 가 나오기 전에 시행하던 Test인데 Comb Pattern을 이용해 Solder Mask 평가나 Flux 잔사에 의한 절연저항의 저하 혹은 PCB 공정 중 오염 정도를 확인하기 위해 진행했다.
지금은 이런 개념들이 CAF에 흡수되어 별도로 하지 않는다(표 3).

표 3. E-Corrosion Test 조건
13. HAST란 무엇이며, 언제 하는가?
HAST(Highly Accelerated Stress Test)는 일반 THB(Temperature, Humidity, Bias) Test 기간이 길어 단축하기 위해 개발된 Test 방법으로서, Pressure Cooker (Autoclave)를 이용한 Test 방법이다. 그림 20과 같은 가혹한 조건을 적용하며, 주로 반도체 Package 제품에서 사용 한다.
Test 기간은 통산 168시간으로 48시간, 96시간 지점에서 품질을 중간 점검한다. 역시 다른 Test와 마찬가지로 샘플은 Precondition한다.
그림 20-(a)는 PCT 장비와 조건을 나타내며 그림 20-(b)는 업체마다 다른 Test 조건 및 JEDEC Spec인 JESD22-A110-B 테스트 조건이다.
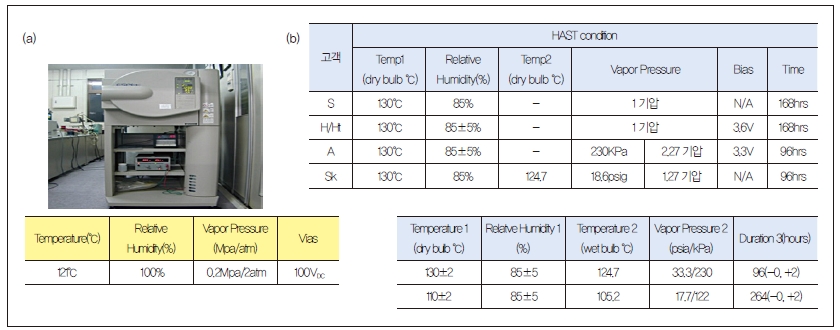
그림 20. Presser Cooker Test and HAST Test 조건
이러한 조건은 너무 가혹하기 때문에 일반 PCB를 적용하면 Delamination과 Migration이 크게 발생한다. 따라서 PCB 분야에서는 IPC나 고객 모두 이러한 조건을 요구하지 않는다(그림 21).
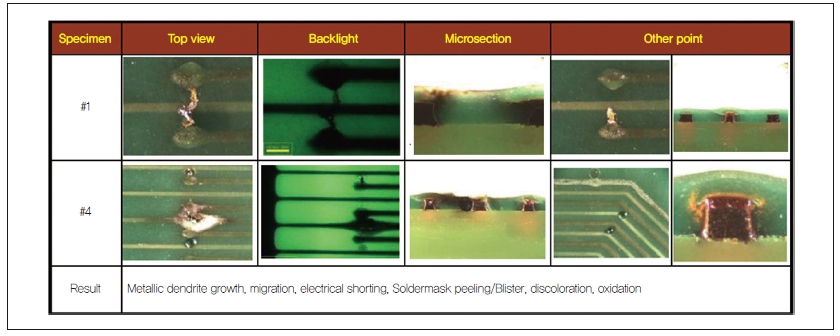
그림 21. HAST Test 결과
14. Creep Corrosion은 어떤 불량이며, 어디에서 발생하는가?
Creep Corrosion은 주로 Immersion Silver Finish에서 발생하는 불량으로서, 주변 환경에 유황(Sulpher)이 있을 때 발생한다.
아래 그림 22에서 확인할 수 있듯이 ECM/CAF과 달리 Electrical Bias가 없어도 발생한다.

그림 22. Creep Corrosion vs ECM(Source : Dr. Randy Scheller)
또한 오염물질(Ionic Contaminent)이 없어도 발생한다. 즉 Moisture, Sulphur, Silver만 있으면 발생하며 Bias 전압으로 발생되는 것이 아니기 때문에 방향성이 없다. Creep Corrosion은 Silver에서 잘 발생하지만 다른 Finish에서도 발생 가능성이 있다.
다음과 같은 순으로 자주 발생한다.
Im Ag > OSP > ENIG >>Im Sn ∼ HASL
Creep Corrosion 이 발생되는 Mechanism은 다음과 같다.
I-Ag Coating이 얇기 때문에 PSR 잔사 등으로 Base Copper가 노출될 경우, 혹은 PSR Undercut 부근에서 Ag 와 Cu 전위차에 의해 Cu·Cu++ +2e반응으로 Cu++가 생기고 Cu++는 S와 반응해 Cu2S가 된다. CU2S는 습기에 의해 용해되어 주변으로 번져나가며(PSR을 타고 올라감), 이 반응은 연속적으로 일어난다(그림 23, 표 4).
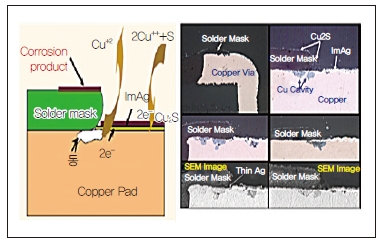
그림 23. Creep Corrosion과 Photos의 메커니즘
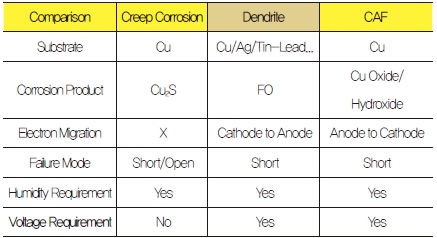
표 4. Creep Corrosion vs Dendrite vs CAF(Source : IST)
15. Migration을 방지하기 위해 어떤 기술이 사용되는가?
Migration을 방지하기 위해서는 Soldering 시 사용된 Flux 잔사를 깨끗이 제거함과 동시에 깨끗한 표면에 Conformal Coating을 함으로서 방지할 수 있다.
Conformal Coating은 사용 환경 내 습기와 Sulphur 성분들을 차단해주는 기능을해 신뢰성이 요구되는 전장, Aerospace, Military 제품에서는 필수적으로 사용된다.
이에 표 5와 같은 재질들이 사용된다.

표 5. Conformal Coating 재료(Source : IPC-CC-830B)
또한 Tin Whisker를 예방하기 위해서도 Conformal Coating이 사용된다. 그러나 Flux 잔사 등 오염된 표면에 Conformal Coating을 했을 경우, Board 표면과 Coating 사이가 들뜨게 되어 그 틈으로 습기가 들어가 Migration을 유발할 수 있다. 그 틈이 Conductive Path이다. 그림 24는 Spray Coater와 Coating 된 PCBA를 나타낸다.

그림 24. Conformal Coating을 위한 Spray Coater
그림 25-(a)는 Flux 잔사로 인해 발생한 Dendrite를 나타내며, 그림 25-(b)는 Flux 잔사로 인해 발생된 White Residue에 의해 발생된 Migration을 나타낸다.
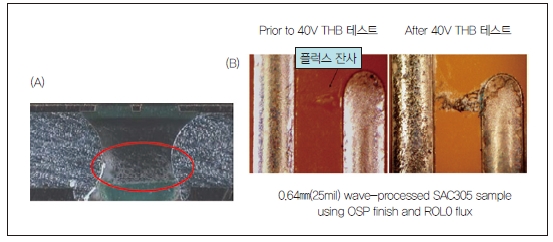
그림 25. Dendrite 성장 시 플럭스 잔사의 역할(Source : CALCE)
그림 26은 실제 Field에서 발생한 Silicon Conformal Coating 들뜬 면에서 발생한 Migration이다.

그림 26. Conformal Coating 아래의 ECM
그림 26-(a)는 Conformal Coating이 PSR면에서 들떠있는 것이며, 그림 26-(b)는 회로 Edge의 PSR 두께가 얇아 동이 Corrosion되고 동이온이 빠져나간 모습을 나타내고 있다. 마지막으로 그림 26-(c)는 PSR과 Conformal Coating 사이 들뜬 면으로 Copper Migration이 진행된 모습을 나타낸다. 상기 불량의 발생 Mechanism은 그림 27과 같다.
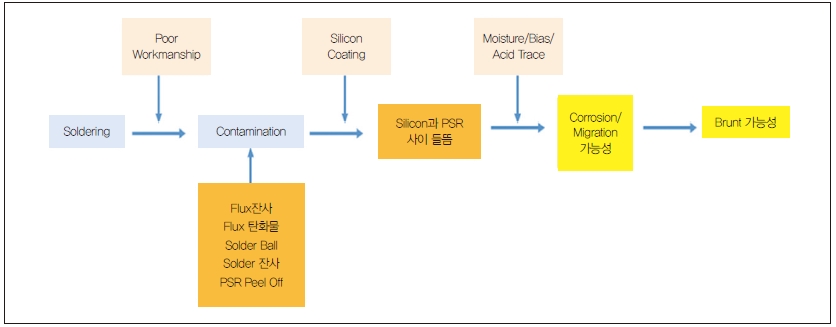
그림 27. Conformal Coating 아래의 ECM 메커니즘
더불어 표 6은 상기 불량에 대한 Corrective Action을 정리한 것으로 참고하기 바란다.

표 6. ECM을 피하기 위한 Corrective Action 정리
결론
현재 산업 현장에선 CAF와 HAST Test를 하는데, 전자는 PCB의 경우고 후자는 Package 관련제품에서 시행하고 있다. 과거에는 E-Corrosion Test, Electrochemical Migration Test, SIR Test 등 여러 가지 Test를 했지만, 현재는 모든 Test가 CAF에 의해 통합되고 있다. CAF는 PCB 내부에서 Migration에 의해 발생되는 불량이지만 CAF Test 시 외부에 Comb이나 Dasy Chain 형태의 쿠폰을 만들어 표면의 ECM도 함께 Test한다.
PCB의 경우는 원판 및 Solder Mask 등 주요 자재를 변경하거나 신규로 사용할 때 CAF로 검증받는다. 또한 분기별과 같이 정기적으로 PCB의 CAF Test를 요구하는 고객을 위해 사용되기도 한다.
CAF Test는 원자재 특성 뿐 아니라 Drill 쏠림이나 Des-mear 공정 시 Wicking 이 과도하게 발생돼 절연거리나 절연층이 감소했을 때, 혹은 Glass Filament를 따라 Dela-mination이 발생했을 때와 같이 공정 중 이상이 발생한 경우도 불량으로 검출하기 때문에 공정 검증 목적으로도 사용된다.
미세 Pitch 부품을 사용함으로써, PCB에서 회로와 회로 사이의 간격이 좁아지고 사용 전압이 높거나 사용조건이 열악한 환경에서 사용되는 제품의 경우, 이 Test가 필요하다.
Pressure Cooker를 사용하는 HAST는 가혹한 환경에서 진행하는 Test이기 때문에 PCB에는 주로 사용하지 않는데, 국내 자동차 업체에서는 요구하고 있다. 이 Test는 Package 분야에서 주로 사용하는데 회로와 회로 사이의 간격이 작아서(예, 50um 이하) 인가전압이 5V이하라도 불량이 발생할 경우가 종종 있다.
이러한 불량은 사용된 Solder Mask의 불순물과 전기적 특성, PCB 제품에서의 Solder Mask Undercut, 사용된 동박의 Profile 형태 및 공정 등에서 영향을 끼칠 수 있는 요인이 많기 때문에 향후 많은 연구가 필요할 것으로 보인다.

이진호 기술위원 전자부품연구원 PCB산업혁신센터

















































